Nettoyage des substrats :
Nettoyage par plasma

Plasma Oxygène
Le nettoyage par plasma oxygène permet d’éliminer les résidus organiques sans utiliser de solvants. Les caractéristiques du Plasma Prep III sont les suivantes :
- puissance : 100 W
- gaz : oxygène (pureté 5.0)
- fréquence : 13.56 MHz
- pression de travail : 200 mTorr
- enceinte en pyrex de 100 mm
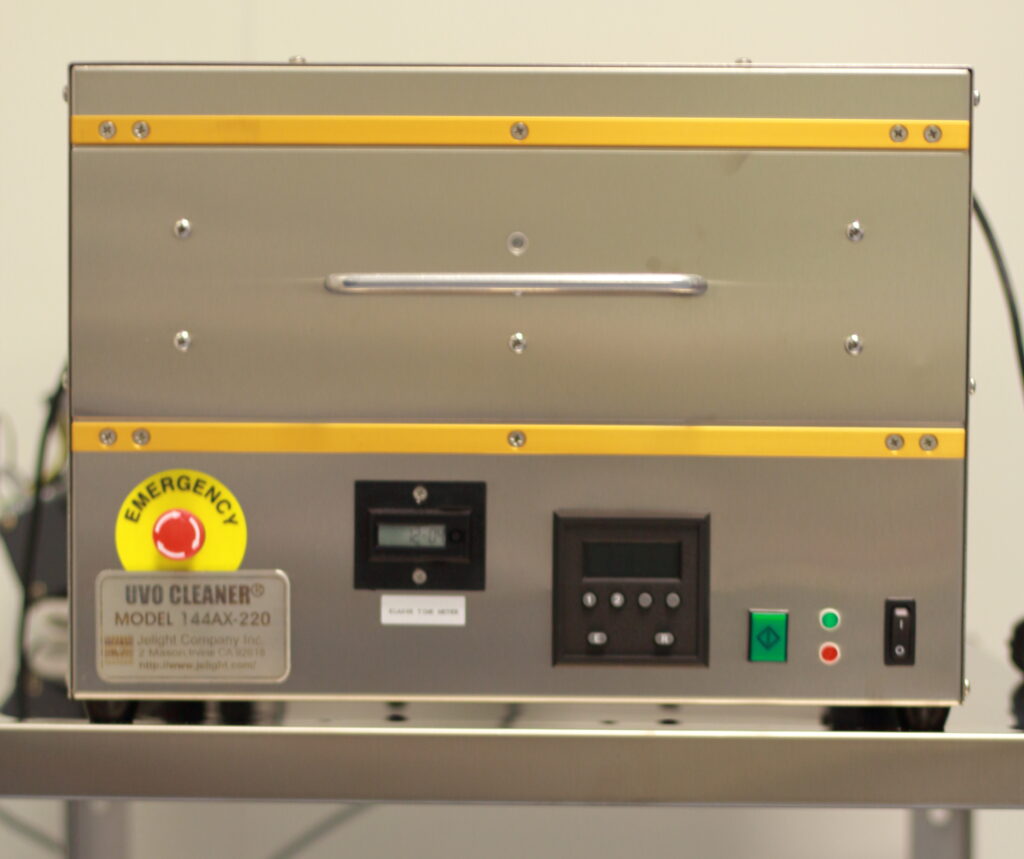
UV/ozone
Le nettoyeur UV/ozone permet de nettoyer les surfaces faiblement contaminé par des résidus organiques. En général, son utilisation est précédé par un nettoyage chimique des surfaces. Cet équipement permet également d’augmenter l’énergie de surface pour une meilleure adhésion des résines par exemple
Nettoyage humide

Solvants
Le nettoyage classique des substrats par des solvants permet d’éliminer des résidus organiques de la surface lorsque ces derniers n’adhèrent pas trop. On utilise dans l’ordre
- Acétone (5-10 minutes)
- Ethanol ou isopropanol (5-10 minutes)
- Séchage à l’azote
Piranha
Lorsque les résidus organiques sont récalcitrants au solvants, il peut être utile d’utiliser un « piranha » qui consiste en un mélange d’acide sulfurique (H2SO4) et de peroxyde d’hydrogène (H2O2). Ce mélange est très efficace pour éliminer les traces de résines sur les masques de lithographie
Consommables disponibles :
I. Produits chimiques
Acides et bases
| Produit | Composition | Ratio en volume |
|---|---|---|
| Hydrofluoric Acid concentrated 40% | HF 40% | |
| Sulfuric Acid | H2SO4 96% | |
| Buffered Hydrofluoric Acid, BOE 7:1 VLSI | NH4F 40% + HF 50% | 7:1 |
| Buffered Hydrofluoric Acid, BOE 25:1 VLSI | NH4F 40% + HF 50% | 25:1 |
| Phosphoric Acid 85% VLSI | H3PO4 85% | |
| Cyclohexanone 99.8% VLSI | C6H10O | |
| Chlorhydric Acid 37% | HCl 37% | |
| Nitric Acid (65%) | HNO3 65% | |
| Acetic Acid (99.8%) | C2H4O2 | |
| Potassium Hydroxyde pellets | KOH 40% | |
| Chromium etch 651826 Aldrich | (NH4)2 Ce(NO3)6; HClO 4 | |
| Copper etch Type CE-100 | ||
| Au etch | KI (40g.), I2 (1g.), H2 O (80 ml) | |
| Hydrogen peroxide 30% | H2O2 30% | |
| Ammonium Fluorid 98% | NH4 | 45gr/100 ml H2O |
| Ammoniaque 28% | NH4OH 28% |
Résines et développeurs
| Produit | Remarques |
|---|---|
| AZ 1505 | photosensitive positive, 0.4 – 1.0 µm |
| AZ 5214 | photosensitive réversible, 0.7 – 1.5 µm |
| AZ nLof 2020 | i-line sensitive negative 1.6 µm |
| AR-P 669.04 et AR-P 679.02 | e-beam positive |
| SX AR-PC 5000/90 | conductive protective coating for e-beam resists |
| MCC SU8-2050 | negative tone epoxy |
| MCC SU8-2100 | negative tone epoxy |
| LOR 3A | non photosensitive |
| Developer MIF 726 | developer for AZ52xx, S18xx |
| Developer AZ | developer for AZxxxx |
| PGMEA | developer for SU8 (1-Methoxy-2-Propanol Acetat) |
| Developer AR 600-56 | developer for AR-P xxx series |
| HMDS Microposit primer | Primer |
| PDMS Sylgard 184 Silicone elastomer | Base + curing agent/td> |
Solvants
| Produit | Composition |
|---|---|
| Ethanol | C2H5O |
| Isopropanol | C3H8O |
| Aceton | C3H6O |
| Remover 1165 | PGMEA, NMP 93% |
| AZ100 Remover | remover for AZxxxx |
| Remover PG | remover of PMGI, PMMA, SU-8 |
| Technistrip NI555 | remover for Novolak-based negative resists |
| Remover AR 600-71 | remover for AR-P xxx series |
| Stopper AR 600-60 | stop development process for AR-P xxx series |
| Extran MA02 neutral | Glass cleaning agent |
II. Wafers
Silicon Wafers
| Name | Diameter [mm] | Thickness [µm] | Orientation | Conductivity type, Dopant | Resistivity range [ohm.cm] |
|---|---|---|---|---|---|
| Si prime wafers 3″ | 75.3 | 350 ± 25 | 100 | P, Boron | 1-3 |
| Si prime wafers 4″ | 100 | 680 | 100 | Intrinsic | 20k |
SiO2 Wafers
| Name | Diameter [mm] | Si wafer Thickness [µm] | oxide Thickness [nm] | Orientation | Conductivity type, Dopant |
|---|---|---|---|---|---|
| SiO2 wafers 3″ | 75.3 | 350 ± 25 | 500 | 100 | P, Boron |
III. Masques
| Nom | Spécifications |
|---|---|
| Chrome Blank 5″ | résolution standard : 4 µm |
| Masque souple 2 – 4″ | résolution minimale : 10µm |

